当前,我国消费电子行业发展迅速,已成为全球生产和消费的主要地区。随着电子产品小型化和多功能化的发展,人们对电子芯片也提出越来越高的要求。电子芯片制造起源和发展都在国外,自电子芯片生产引进国内后,国内芯片生产相关材料也引起了极大重视。在电子芯片制造工艺流程中,底部填充胶起着至关重要的作用。虽然用量较少,在芯片制造成本中所占的比例较低,但目前其市场基本依赖进口,国内目前存在较大缺口。
在电子封装过程中,电子元器件是由不同线膨胀系数的材料组成。在热循环下,由于膨胀尺度不同会产生热应力差,进而产生相对位移,导致整个元件失效,而底部填充是避免此现象产生的有效方式。
底部填充胶,又称为底填胶、底部填充剂、底填剂和底充胶等,即在封装时渗入到芯片、焊柱和基板之间形成可靠粘接,分散芯片在受到机械作用和热循环作用时其焊点处所受的应力,避免开焊和不良焊点的产生。此外,底部填充胶还可以起到保护焊点免受湿气、离子污染物等周围环境影响的作用。底部填充胶极大地提高了封装稳定性和产品的使用寿命,目前主要用于笔记本电脑、USB、手机等手提电子产品的线路板组装。一般将底部填充胶分为芯片级底部填充(CLU)和 PCB 板级底部填充(BLU),其中芯片级底部填充对封装胶要求更加严格。
电子芯片高集成化和高性能化的发展,对底部填充胶的性能提出了更高要求。根据工艺和使用性能,底部填充胶需要具备易操作、快速流动、快速固化、长使用寿命、高粘接强度和低模量的基本特点,同时还要满足填充性、兼容性和返修性等。
可靠性:经过温湿、冷热冲击和机械冲击后,电性能和粘接性能稳定。底部填充胶的热膨胀系数(CTE)、玻璃化转变温度(Tg)以及模量系数(Modulus)等,要与 PCB 基材、器件的芯片和焊料合金等因素进行匹配,胶粘剂的 Tg 对 CTE 有着重要的影响。当温度低于 Tg 时,CTE 较小,反之则 CTE 急剧增加。模量系数为物质的应力与应变之比,模量是胶粘剂固化性能的重要参数,模量较高则表示胶粘剂的粘接强度与硬度较好,但也代表着胶粘剂固化后残留的应力较大。
操作性:胶粘剂的流动性与锡球间距、锡球尺寸有关。不同间隙高度和流动路径,导致流动时间也不同,如需保证快速完全填充,则要求胶粘剂黏度低、流动快;但黏度也不能过低,否则生产过程中容易滴胶。一方面填充胶的表面张力、接触角、黏度和硬化反应可对填充胶在芯片和电路底板之间流动产生影响,其中黏度为最主要因素,温度则是影响填充胶黏度的重要因素;另一方面焊球点的布置密度和边缘效应对芯片和电路底板之间流动也有一定影响,焊球点之间缝隙的宽度、焊球点的直径、芯片与电路底板之间的缝隙高度决定了焊球点产生的影响。
效率性:底部填充胶的固化温度应适当,以保护主板上的其他电气器件及焊点。同时,固化速度要快,过长的固化时间会影响流水线作业的效率。此外,固化方式需要满足大批量生产需求。
耐热性:胶粘剂的线胀系数(CTE)与基材线胀系数要相匹配。且仅有材料的 CTE 较小时,Tg 对热循环疲劳寿命才有一定影响,因为当材料温度高于 Tg 和低于 Tg 时,其 CTE 变化差异很大。同时相关试验表明,当 CTE 较低时, Tg 越高热循环疲劳寿命就越长。电子元器件在工作时会发热,需要固化物有良好的耐热性。
耐腐蚀性:低氯离子含量和金属离子含量均可减缓微线路腐蚀。
兼容性:焊点周围存在锡膏残留的助焊剂,如果底部填充胶与残留的助焊剂不兼容,会导致底部填充胶无法有效固化。
可检验性:固化前后颜色明显变化,或通过紫外照射出现颜色变化,方便检验固化或填充情况。
返修性:底部填充胶通常要求具有可返修性,因为在线路板组装完成后,如在整板测试中发现芯片不良等情况,需对芯片进行返修。为降低成本、避免废品的产生导致整个电路板的报废,对底部填充胶的可返修性要求与日俱增。
功能性:要求低应力、低 CTE、与锡膏兼容性、绝缘电阻及良好填充效果(无气泡、空洞)等。
电子级封装涉及的粘接基材均为精密器件,具有尺寸小、功能化(介电性能、力学性能、耐腐蚀性能、导热等)和所处环境非常规(如高温高湿、温度变化、应力冲击等)等特点。
3.1 胶粘剂在固化中收缩产生的应力问题
胶粘剂在固化中由于键长改变会产生收缩问题(一般为 3.5~1.4 Å),胶粘剂从液体到凝胶状态、到达到 Tg、再到完全固化,期间受凝胶、固化温度和 Tg 的影响,不同阶段的状态都不相同,影响因素较多且缺乏过程的表征手段。由于整个过程中会产生不同程度、不同原因的收缩,产生较大的内应力,所以容易导致粘接失效,包括胶层失效(裂纹)、粘接失效(脱附)和器件失效(器件受力变形或破坏)。
目前减小材料的固化收缩率主要是通过添加填料的方式,但其调节能力有限,若大量使用,会导致黏度、模量等大幅度变化,反而不利于底部填充。因此,底部填充胶的应力收缩问题是目前该类材料应用的主要问题之一。
3.2 胶粘剂的线胀系数与基材的线胀系数匹配问题
由于电子器件应用温度随着使用环境的变化而变化,导致同类器件可能在低温下应用,也有可能在高温下应用。另外由于电子器件发热等情况带来的局部高温环境不同,甚至固化过程也会发生温度的改变。胶粘剂的 CTE 一般比所粘接器件的CTE 要高,当温度改变时,会在粘接界面产生应力,温度变化量大时甚至会导致局部产生应力开裂。
目前常用的方法是通过添加低膨胀填料进行改进,对填料的要求也比较高,如小粒径会导致黏度上升,填充时粒径不超过缝隙的 1/4,一般光栅阵列间相距 25 μm,因此需要胶粘剂的黏度较低且容易流动填充。这就带来了因填料引起的黏度不匹配与CTE 矛盾的难题。胶粘剂的导热系数不高,导热系数达到 2.8 W/(m·K)很困难,可通过加入填料,改变其数目比和尺寸比进行提升,但提高程度也会影响胶粘剂的其他工艺特性。因此集多种矛盾为一身的体系如何寻求突破是一大难点,目前国外的原料制造水平较高,有专注于通过研究特种结构的环氧树脂来解决此问题。
3.3 胶粘剂纯度控制和质量稳定性问题
底部填充胶主要成分为环氧树脂,由于大部分环氧树脂合成是通过环氧氯丙烷开环闭环的工艺路线,会产生含氯副产物。而氯离子在电子器件的应用过程中会腐蚀基材,导致粘接失效,氯离子迁移也会影响电子器件的光电性能。由于在合成阶段难以控制环氧树脂中氯的源头问题,要获得低氯离子含量环氧树脂就需要进行纯化,即使用将已合成树脂进行再反应的方法进行提纯,从而达到电子级的使用要求(氯离子含量<50 g/kg)。目前,以日本为代表的国外企业在电子级环氧树脂方面发展迅速但对外垄断,而国内高纯低氯环氧树脂发展水平较低,存在产品纯度不高和质量稳定性差等问题,极大地限制了环氧树脂在电子领域的应用。
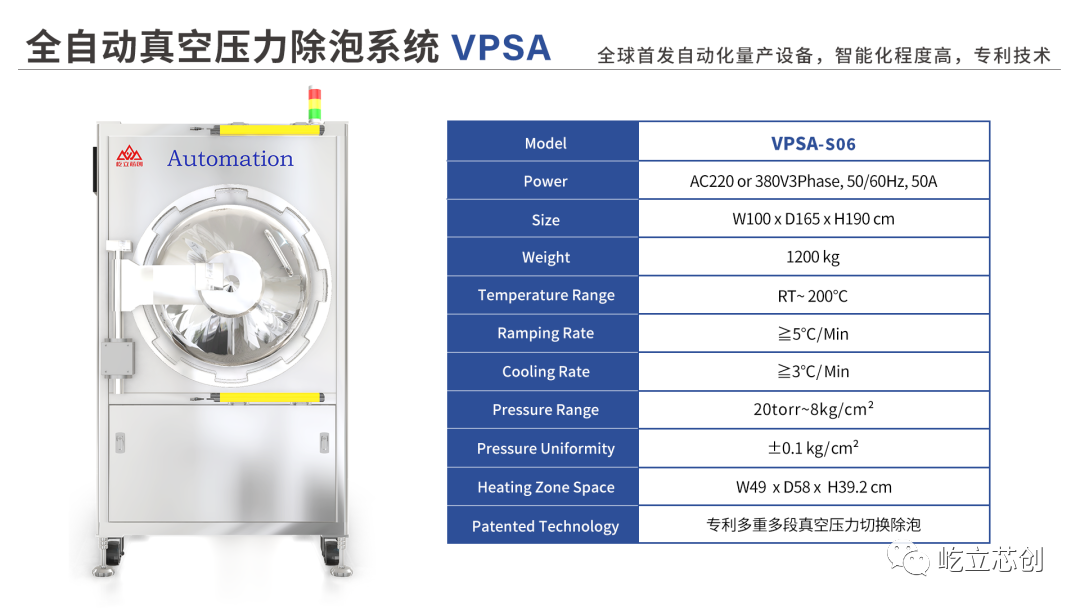
独家专利除泡能力,全球首发自动化设备,智能化系统布设可对接OHT-AGV等自动化产线设备。
采用多重多段真空/压力切换系统,根据工艺及材料需求设计最佳除泡方案,辅助以微压力控制系统;
固化品质高采用双腔体、双温控系统,屹立芯创先进控温技术,控温精度高达±1°C,可实时监控温度并生成温度曲线;炉内温度均匀性好,固化品质高,一致性好;
更可靠结构设计及零件经上百次优化迭代,结构更简洁、实用,不易出故障;先进的零件性能更加出色,使设备的运行稳定性更强,满足连续式、大批量生产要求;
采用智能化系统布设可对接OHT-AGV等自动化产线设备可对接MES系统,保证生产安全及产品良率。
屹立芯创本着优先让客户成功的经营理念,一直致力于除泡品类设备的研发,经过20多年的技术经验积累,目前已成功量产符合多种工艺材料需求的除泡设备,实现了完全国产化并在多个国家或地区广泛使用,成为中国封测领域解决除泡问题的排头兵。

———————
获取封装测试服务
电话:4000202002;13327802009
地址:南京市江北新区星火北路11号
官网:
邮箱:info@elead-tech.com