底部填胶Underfill工艺流程
Deflux助焊剂清洗
对于常规Flip Chip工艺的产品来说,倒装上芯后,Bump与基板Pad 焊接状态十分重要。焊接完成后,若不能将残留未挥发助焊剂及时清理,那么在接下来的Underfill作业时,由于Bump间隙残留的助焊剂与底填胶不相溶,在固化时助焊剂进一步挥发后,极易产生填充空洞。
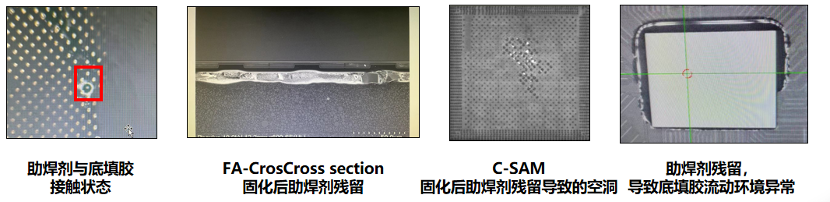
UF Prebake底部填充前烘烤
常规半导体树脂封装基板由有机高分子材料组成,极性有机分子易于吸附水分子,且树脂材料基板比陶瓷基板浸润性更强。待加工产品经过助焊剂清洗后,水汽附着于基板表面,为了避免这个风险的存在,因此在Underfill制程的第一步,填充前先进行Prebake 操作,以减少此类风险的发生概率。

UF Pre Plasma填充前等离子清洗
底部填充前的最后一个准备工作即为Plasma清洗。等离子清洗就是通过利用其活性组分的性质来处理样品表面,从而实现清洁、活化、改性、等目的。
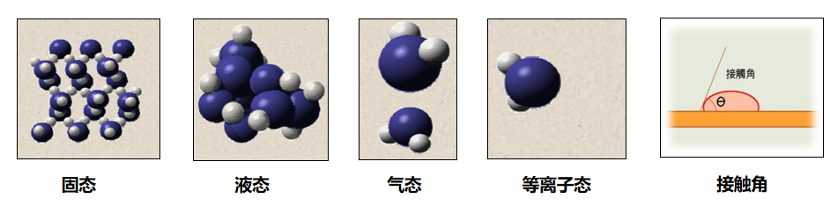
Underfill底部填充-点胶
Underfill底部填充-点胶:在新产品评估阶段,根据产品设计图纸信息及底填胶材料要求,先行确认目标产品是否满足底填工艺需求并识别对应作业风险点,确定基本点胶参数。
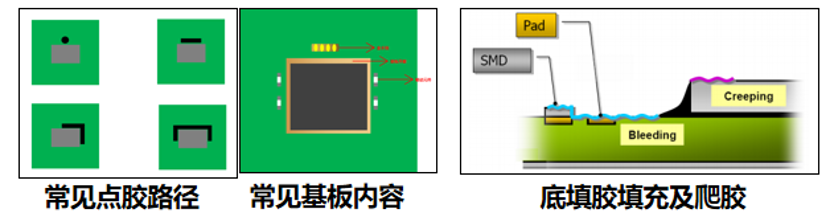
UF Post Cure除泡固化
根据常规底部填充胶的特性,在产品点胶作业后,需要根据底填胶的感温固化特性,按照一定的温度时间参数进行加热固化,以此来保护焊点与芯片在受到碰撞与冲击时的可靠性。
在实际生产应用中,底部填胶过程经常会由于基板设计、Bump 排布不规则、工艺制程能力限制等原因,不可避免的存在包裹气泡现象,气泡如果不被清除,其通常会在芯片的加热循环中迅速膨胀,与膨胀气体相关的力会导致焊料连接开裂或芯片变得不可靠。这就需要应用一定的工艺手段,在post Cure 阶段完成除泡工作。
通常,除泡过程需在gelation temperature(凝胶化温度)以下完成。所以,底部填充后固化过程的温度曲线往往是多段式的(低温除泡、高温固化)。当前,行业内普遍认为最有效的除泡方式为在固化过程加入压力&真空进程,采用专用除泡系统是最快捷且高效的除泡方式。

Underfill固化后产品外观检验
产品在UF站作业完成后,需进行外观检验,Underfill 检验标准通常包含以下几点:
KOZ——基板底填胶远端至芯片边缘距离标准确认是否超标;
爬胶高度——底填胶与芯片边缘接触的Z轴高度
芯片表面Creeping——环氧树脂爬升至芯片表面时的宽度
Underfill Crack——Underfill固化后产生的胶材裂纹,通常不允许存在此现象;
底填胶覆盖被动元器件情况——基板方向底填胶是否覆盖被动元器件;

C-SAM超声波扫描
超声波显微镜 (SAT)在Underfill制程检测中,普遍使用的模式为二维反射式平面检测/图像(C-Mode),因为称之为C-SAM。此检测为应用超声波与不同密度材料的反射速率及能量不同的特性来进行分析,来检验材料内部的缺陷并依所接收的信号变化将之成像。
图片
RA-可靠性实验
对于半导体封装来说,在新产品新工艺导入阶段,验证产品作业完成后,通常需要通过一系列可靠性实验进行分析确认,若实验结果无法通过,则需要优化工艺制程。
如下列举Underfill常用可靠性分析项目:
跌落实验(Drop Test)、弯曲实验(Bend Test)、温度循环(TCT)、高温存储实验(HTST)

FA-失效性实验
在封装过程中,产品出现各类异常时有发生,通过失效分析技术确定如何以及为什么失效,了解是什么引起的失效以及如何预防,对于产品工艺提升十分重要。
如下列举Underfill常用失效性分析项目:
外观镜检、T0-SAT、3*IR-SAT、Cross section(SEM)、EDX、P-Lapping

底部填胶Underfill工艺
01
难点分析
焊接完成后,若不能将残留未挥发助焊剂及时清理,那么在接下来的Underfill作业时,由于Bump间隙残留的助焊剂与底填胶不相溶,在固化时助焊剂进一步挥发后,极易产生填充空洞。
02
预烘烤水分残留,若基板在预烘烤后仍含有水分,那么水分便会在这个过程中向上挥发,从而造成填充空洞现象。
03
在实际生产应用中,底部填胶过程经常会由于基板设计、Bump 排布不规则、工艺制程能力限制等原因,不可避免的存在包裹气泡现象,气泡如果不被清除,其通常会在芯片的加热循环中迅速膨胀,与膨胀气体相关的力会导致焊料连接开裂或芯片变得不可靠。
底部填胶Underfill工艺解决方案

除泡品类·高温真空压力除泡系统
根据常规底部填充胶的特性,在产品点胶作业后,需要根据底填胶的感温固化特性,按照一定的温度时间参数进行加热固化。通常,除泡过程需在凝胶化温度以下完成,胶材在凝胶化时,气泡被抽除时无法闭合会形成细长条气泡型态。因此,底部填充后固化过程的温度曲线是多段式的,在固化过程加入压力&真空进程,采用专用除泡系统是最快捷且高效的除泡方式。
点胶机
除泡品类应用优势
以此从理论知识到实际工程应用,20+年丰富案例经验积累让我们可以在解决Post-assembly Underfill 中出现的气泡问题的同时,亦可帮助客户大幅提升UPH、降低生产风险与成本、提高产品良率与可靠性。
01更强生产链适应性
02更高除泡良率
03更高拓展性
04更好的成本效益
屹立芯创·除泡品类开创者
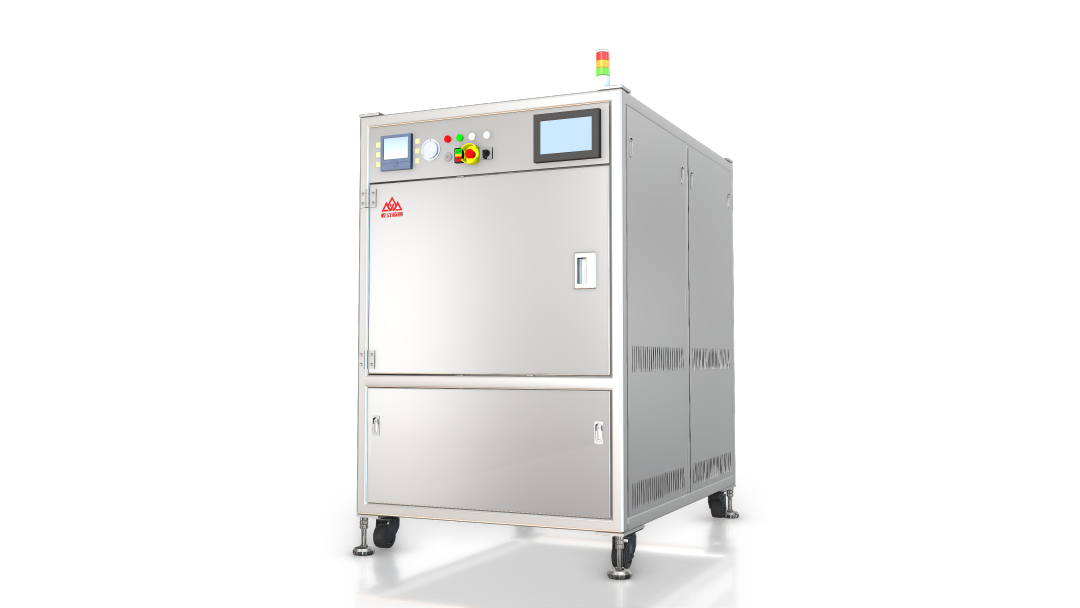
公司简介
屹立芯创作为除泡品类开创者,以核心的热流和气压两大技术,持续自主研发与制造除泡品类体系,提升良率助力产业发展,专注解决半导体先进封装中的气泡问题,为客户定制半导体产业先进封装领域,多种制程工艺中的气泡整体解决方案,现已成功赋能半导体、汽车、新能源、5G/IoT等细分领域。