晶圆贴膜机是半导体制造业中应用广泛的设备之一,用于将保护膜或封装材料覆盖在晶圆表面,以保护芯片免受粉尘、氧化和潮湿等外界影响。在半导体行业,安全和性能至关重要,因此,晶圆贴膜机必须遵守国际标准和安全要求,如SEMI S2标准。

SEMI S2标准是半导体设备和材料国际协会(SEMI)颁布的标准,旨在确保在使用和维护半导体制造设备时保护操作人员和生产线的安全。因此,晶圆贴膜机如要满足SEMI S2的要求和认证流程,需要考虑以下几个方面。

首先,晶圆贴膜机应具有完备的安全电气控制系统。包括但不限于应具备自动停止功能,当安全门或罩关闭时可以停止运行;应当具有防止损坏半导体芯片的电荷控制和电场控制;还应当有过载保护和过温保护等安全措施。所有这些安全措施都应预先设置并经过验证,以确保操作人员和生产线安全。

其次,晶圆贴膜机的贴膜精度必须符合SEMI S2标准的相关要求。这意味着机器必须能够将膜材料均匀地贴附到晶圆表面,而不会留下气泡、皱纹或折痕,并在多次操作后保持一致的贴膜精度。在此过程中,任何机器缺陷或操作失误都可能危及芯片的完整性,因此必须确保贴膜精度的一致性和准确性。

此外,晶圆贴膜机的材料必须符合SEMI S2标准要求。机器使用的所有材料和组件必须经过认证和审核,并且必须合适且适用于晶圆贴膜机及其工作环境。这些材料可能包括贴膜的胶片、刀具、气体管道等。因此,外部供应商必须严格遵守SEMIS2标准,并且机器制造商必须保证所使用的材料是符合标准的。
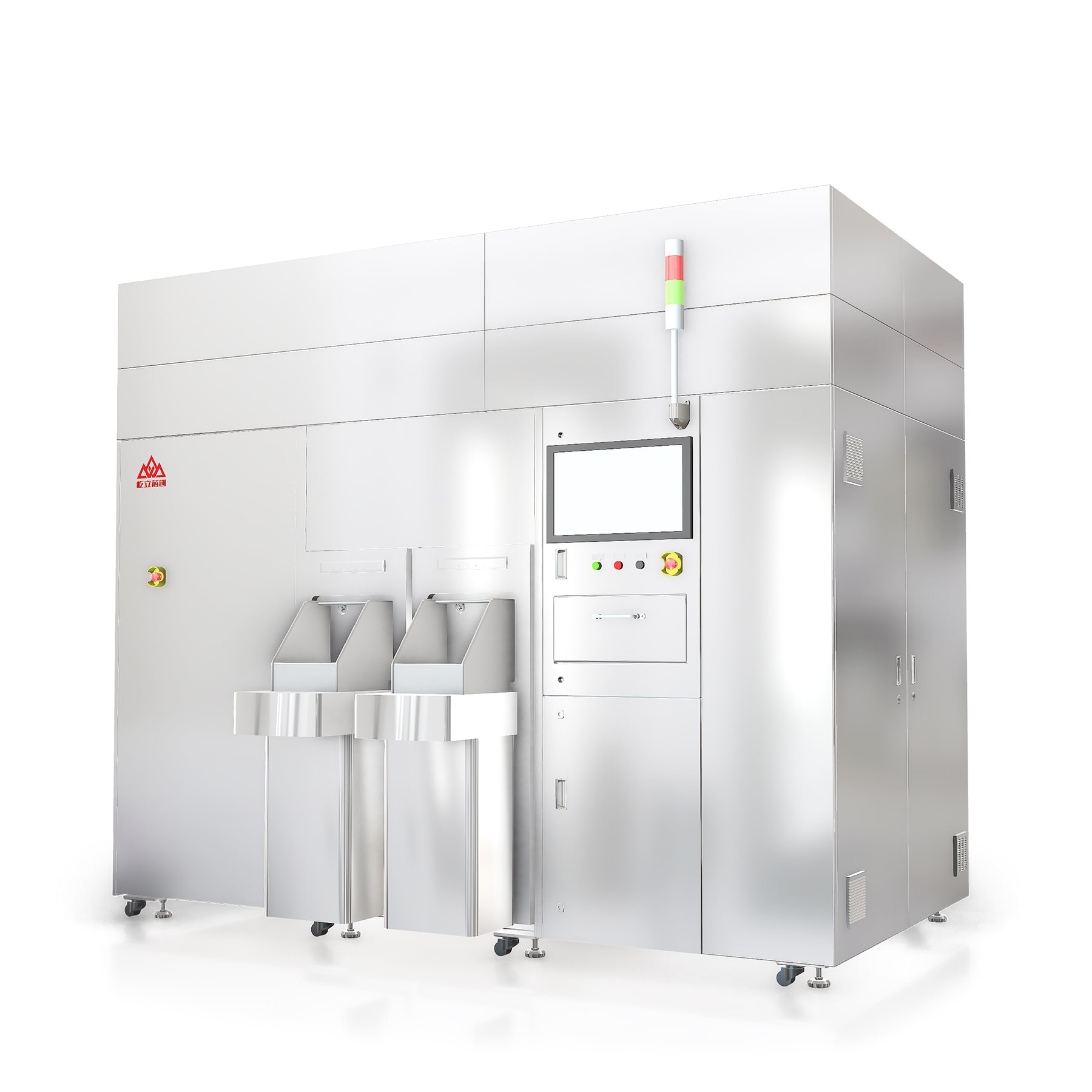
在总结SEMI S2标准对晶圆贴膜机的要求和认证流程时,需要考虑到各个方面的因素。机器必须具有完备的安全电气控制系统,并且贴膜精度必须一致而精确。材料选择也必须符合标准,以确保机器和晶圆的安全和完整性。因此,在选择晶圆贴膜机时,必须确保其符合SEMI S2标准。

屹立芯创 晶圆级真空贴压膜系统实现多项核心技术突破,符合SEMI S2国际认证。创新的真空下贴压膜和独家开发的软垫气囊式压合专利技术,有效解决因预贴膜在真空压膜过程中产生气泡或是干膜填覆率不佳的问题。尤其适用于TSV等凹凸起伏的晶圆表面,可轻松实现1:20的高深宽比填覆效果。真空/压力/温度实现多重多段设置,内部搭配自动切割系统,适配多种干膜材料,还可扩充压膜腔体进行二次表面整平压合,无须另外加装整平系统,助力企业智慧升级。
———————————
屹立芯创 · 除泡品类开创者
屹立芯创作为除泡品类开创者,深耕半导体先进封装技术20余年,专注解决半导体先进封装中的气泡问题,提供多种制程工艺中的气泡整体解决方案。对Mini/Micro LED、芯片贴合Die Attached、灌注灌封IGBT Potting、底部填胶underfill、点胶封胶Dispensing、OCA lamination等工艺拥有成熟应用经验。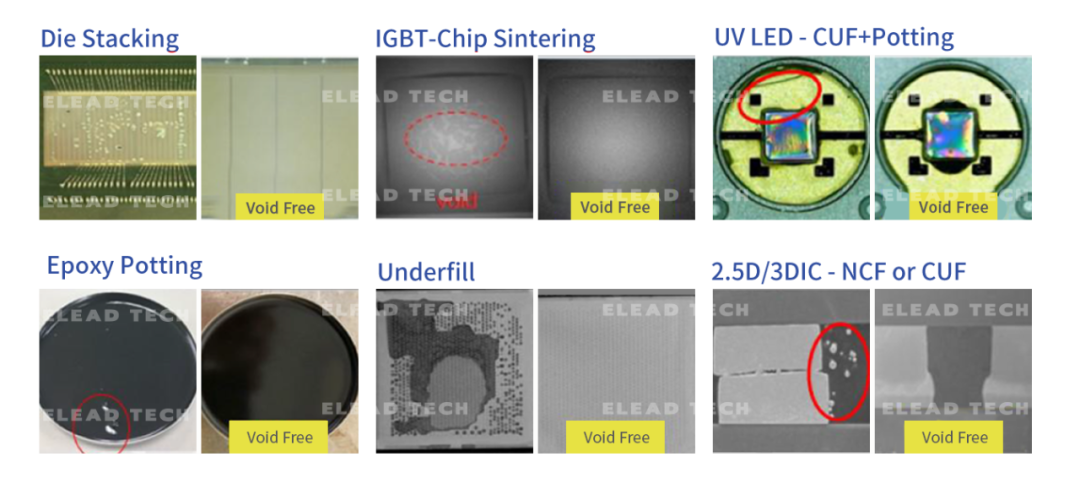
获取封装测试服务
电话:4000202002;13327802009
地址:南京市江北新区星火北路11号
邮箱:info@elead-tech.com